SK Hynix startet HBM4-Produktion und setzt auf neue Verpackungstechnik
03.03.2026 - 20:00:43 | boerse-global.de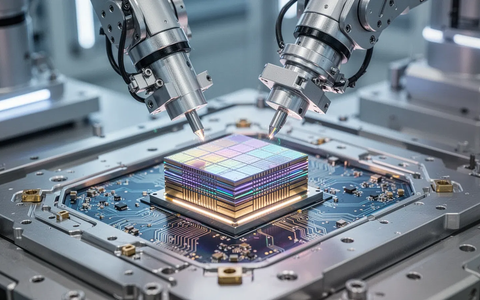
Der südkoreanische Halbleiterriese SK Hynix hat die Serienfertigung seines neuen Hochleistungsspeichers HBM4 aufgenommen. Diese Technologie ist entscheidend für die nächste Generation von KI-Acceleratoren, darunter NVIDIAs kommende „Rubin“-Plattform. Der Produktionsstart offenbart jedoch die zentrale Herausforderung der Branche: Nur mit revolutionären Verpackungs- und Testverfahren lässt sich das volle Potenzial der schnellen Speicher ausschöpfen.
Bewährte Technik für den Serienstart
Für die ersten HBM4-Module setzt SK Hynix zunächst auf erprobte Verfahren. Das Unternehmen nutzt seine etablierten Thermo-Compression (TC)-Bonder, um die Speicherchips über Mikro-Lötpunkte zu stapeln. Diese Methode wird durch die firmeneigene MR-MUF-Technologie (Mass Reflow Molded Underfill) verfeinert, die bereits bei Vorgängergenerationen zum Einsatz kam.
Mit dem rasanten Fortschritt bei KI-Hardware steigen auch die Anforderungen an die digitale Sicherheit und rechtliche Compliance in Unternehmen. Dieser kostenlose Leitfaden zeigt Geschäftsführern, welche neuen KI-Gesetze und Sicherheits-Trends den Betrieb 2024 maßgeblich beeinflussen. Was Geschäftsführer über Cyber Security 2024 wissen müssen
Der Grund für diese konservative Anfangsstrategie ist pragmatisch: Sie gewährleistet stabile Ausbeuten und hohe Produktionsvolumen von Beginn an. Gleichzeitig kauft das Unternehmen Zeit, um die nächste Verpackungsrevolution vorzubereiten. „Man setzt auf das bewährte Verfahren, um lieferfähig zu sein, während im Hintergrund die Zukunft entwickelt wird“, erklärt ein Branchenkenner.
Hybrid Bonding als nächster Quantensprung
Die eigentliche Zukunft der HBM-Verpackung heißt Hybrid Bonding. Dieses Verfahren verzichtet auf die störanfälligen Lötpunkte zwischen den Chips. Stattdessen werden Kupferkontakte direkt miteinander verschmolzen. Das Ergebnis: dünnere Stapel, geringerer Widerstand und eine deutlich verbesserte Wärmeableitung.
SK Hynix bereitet den Wechsel aktiv vor. Zwischen April und Mai 2026 will das Unternehmen mit der eigenen Prozess-Validierung für Hybrid Bonding beginnen. Diese Technik wird unverzichtbar für künftige Speicher mit 20 oder mehr Lagen – eine Stapelhöhe, die mit heutigen Methoden kaum zu realisieren ist. Auch Konkurrenten wie Samsung investieren massiv in diese Schlüsseltechnologie, insbesondere für die übernächste Generation HBM4E.
Eigenes Test-Equipment stärkt Unabhängigkeit
Ein strategischer Coup von SK Hynix ist die Entwicklung eigener System-Level-Testgeräte für HBM4. Diese interne Lösung hat Anfang 2026 die Qualifikation bestanden. Bislang lag diese komplexe Prüfung, bei der die Funktionsweise des Speichers im Verbund mit einem Grafikprozessor getestet wird, in der Hand von Partner-Foundries wie TSMC.
Die neue Eigenständigkeit hat große Vorteile. SK Hynix kann nun Integrations- und Kompatibilitätsprobleme frühzeitig erkennen und beheben, bevor die Speichermodule an Kunden wie NVIDIA ausgeliefert werden. Dies ist umso wichtiger, als HBM4 zunehmend maßgeschneidert für bestimmte KI-Architekturen wird. Das Unternehmen positioniert sich so vom reinen Komponentenlieferanten zum Lösungsanbieter.
Treiber ist der unersättliche KI-Hunger
Der Druck für diese Innovationen kommt direkt von den KI-Pionieren. NVIDIAs nächste Plattformen verlangen von HBM4 Geschwindigkeiten, die den Basissstandard bei weitem übertreffen. Das stellt immense technische Hürden an Rauschunterdrückung und Stromversorgung innerhalb des Speicherstapels. SK Hynix hat bereits spezielle Verpackungslösungen entwickelt, um genau diese Herausforderungen zu meistern.
Für die langfristige Umsetzung dieser Vision investiert der Konzern massiv. In Cheongju entsteht ab April 2026 eine neue 13-Milliarden-Euro-Fabrik für fortschrittliche Verpackung und Tests (P&T7). Die Fertigstellung ist für Ende 2027 geplant. Die Anlage wird mit neuen DRAM-Fertigungsstätten zu einem integrierten HBM-Produktionszentrum verschmelzen. Zudem bleibt die strategische Kollaboration mit TSMC bei der Herstellung der HBM4-Basis-Logik ein kritischer Pfeiler der Roadmap.
Die Branche blickt nun gespannt auf die zweite Hälfte 2026, wenn die ersten KI-Chips mit HBM4 auf den Markt kommen sollen. Während bewährte Methoden den Start ermöglichen, wird der erfolgreiche Einsatz von Hybrid Bonding und modernstem System-Testing den nächsten Marktführer im milliardenschweren Rennen um den KI-Speicher bestimmen.
So schätzen die Börsenprofis Aktien ein!

Für. Immer. Kostenlos.

